
(926)274-88-54
Бесплатная доставка.
Бесплатная сборка.
График работы:
Ежедневно. С 8-00 до 20-00.
Почта: soft_hous@mail.ru
 |
Звоните! (926)274-88-54 Бесплатная доставка. Бесплатная сборка. |
Ассортимент тканей График работы: Ежедневно. С 8-00 до 20-00. Почта: soft_hous@mail.ru |
  
|
Читальный зал --> Солнечные элементы водам, полученным при моделировании аналогичных процессов в Si [см (7.7)]. Существует ряд методов для минимизации или снижения последстви!! радиационных повреждений. Отжиг после радиационного воздействия (например, при температуре 200° С в течение 30 ч) приводит к восстановлению большей части потерянной эффективности [Walker, Conway, 1978]. В фотопреобразователях с переменной шириной запрещенной зоны за счет тянущих полей слабее ощущается снижение L под влиянием такого воздействия. Детальный анализ структур с двумя ширинами запрещенной зоны указал на существенное возрастание радиационной стойкости подобных структур [Hutchby, 1978]. Этот вьшод в особенности важен для фотопреобразователей, содержащих слой AlGaAs, поскольку создание переменной ширины запрещенной зоны легко осуществимо в процессе выращивания AlGaAs методами жидкофазной эпитаксии или химического осаждения из паровой фазы. 5.2.6. Арсенид-галлиевые солнечные элементы с переменной шириной зоны и барьерами Шоттки Целесообразность создания переменной ширины запрещенной зоны путем варьирования состава обусловлена следующими различными, но взаимосвязанными причинами. Во-первых, переменный состав слоя - естественное обобщение концепции широкозонного окна-фильтра, направленное на оптимизацию прохождения и поглощения света в слое, на тьшьной стороне которого сформирован р - и-переход. Во-вторых, переменный состав и обусловленные им электрические поля большой напряженности вблизи лицевой поверхности способствуют отражению носителей от нее и снижению потерь, связанных с поверхностной рекомбинацией. В-третьих, наличие электрических полей высокой напряженности в генерационном обьеме существенно повышает эффективное значение диффузионной длины неосновных носителей: Ieff-LnoiSgLnoKkT)). Эти идеи обсуждали уже давно, но воплотить их в жизнь стало возможным лишь с появлением идеальной для зтих целей системы AlGaAs - GaAs. Например, еще в 1975 г., по-видимому, Тайц впервые предложил идею снижения поверхностной рекомбинации за счет создания электрического поля в слое переменного состава. Им же объяснен эффект возникновения ЭДС в освещенном полупроводнике с переменной шириной запрещенной зоны. Эта теория бьша затем распространена на случай, когда не только ширина запрещенной зоны, но и подвижности, времена жизни, концентрации носителей и их эффективные массы зависели от положения в полупроводнике [Marfaing, Chevallier, 1971]. При сравнении расчетных и экспериментальных результатов для структур HgxCdi.Te обнаружили почти полную их идентичность. При высоких уровнях освещенностей в этих структурах наблюдали небольшую ЭДС (не более 1,5 мВ). 208 Был проведен детальный (и достаточно критический) анализ с помощью ЭВМ солнечного злемента на основе структуры n-AlGaAs-p-GaAs с переменным составом [Hutchby, Fudurich, 1976]. При анализе использовали зкспериментальные значения параметров материалов и учитывали все известные механизмы энергетических потерь, в том числе и в просветляющих покрьггиях. Расчеты показали, что для получения максимального РСПД = 17,7% при АМО состав слоя AlGax.As толщиной 1 мкм должен изменяться таким образом, чтобы х менялся от 0,35 до 0. Переменный состав способствует повьппению радиационной стойкости, несмотря на деградацию Z, и 5. Методом изотермической рекристаллизации с подтравливанием были выращены слои толщиной от 0,2 до 0,4 мкм р-Al: Gaj хAs с изменением состава от х 0,9 до х = 0 по глубине. Помещенный над подложкой n-GaAs раствор Ga - А1-Zn бьш слегка недонасыщен. Поэтому на начальной стадии происходило небольшое подтравливание поверхности подложки, а затем начинался рост переменного по составу слоя AIGaAs из-за концентрационных градиентов, установленных в расплаве на стадии травления подложки. В результате диффузии Zn в процессе выращивания формировался слой p-GaAs: Zn толщиной 0,8-2 мкм. Солнечные элементы при AMI имели КПД 21,8% (т? = 18,4% в условиях освещения АМО под имитатором) и повьппенную чувствительность в коротковолновой части спектра. При профилировании состава с помощью Оже-злектронной спектроскопии в слоях AIGaAs толщиной 0,2 мкм, изготовленных тем же способом, бьшо установлено, что переменный состав соответствует расчетным профилям, полученным в предположении диффузии алюминия через концентрационный градиент в расплаве вблизи ростовой границы [Kordos е. а., 1979]. Исследования показали, что толщину слоя переменного со-, става (а также глубину травления поверхностного слоя подложки можно варьировать в диапазоне от 0,15 до 0,25 мкм изменением степени не-досыщения расплава. Этим способом получены солнечные элементы со значительной улучшенной спектральной чувствительностью в диапазоне больших энергий фотонов [Kordos, Pearson, 1981]. Среди солнечных элементов с барьером Шоттки стоит упомянуть интересную структуру Аи-я-AIGaAs-и-GaAs [Shen, Pearson, 1979]. Теоретически в зтом случае (рис. 5.12) значение /jc должно быть таким же большим, как в обычном элементе со стр)тстурой Аи -n-GaAs, а Vqc - значительно превышать напряжение холостого хода обычного элемента. В эксперименте было получено хвеличение Vqc от 0,53 до 0,70 с ростом мольной доли X А1 от О до 0,5. Разница Ь.Е между шириной запрещенных зон GaAs и AlxGaj.As (AEg ~ 0,4 зВ при X = 0,3) препятствует движению дырок к Аи (рис. 5.12,а), и позтому слой AIGaAs должен бьпь настолько тонким, чтобы и AIGaAs, и GaAs бьши обеднены вблизи гетероперехода, а сама его граница попадала в область сильного электрического поля. Из рис. 5.13 видно, как сильно зависит спектральная чувствительность злемента от толщины слоя AIGaAs. Семейство подобных кривых наблюдается при изменении обратного смещения Vj в злементах с более трл- И-Зак 609 209 Обедненная , область . Гетеропереход Вакуум 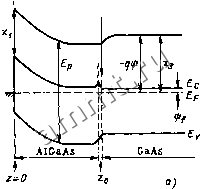 Юбедненная j41 &aAs Гетеропереход Рис. 5.12. Энергетическая зонная диаграмма солнечного элемента на основе структуры Аи - л-GaAlAs - л-GaAs с барьером Шоттки: а - толщина слоя AlGaAs превьшгает щирину обедненной области; б - толщина слоя AlGaAs меньше ширины области обеднения 1,гт 0,8856 0,5635 100 -80 - X 60 - го - 0,4768 г, мкм т-1-1- Au-GaAs с1=80нм 500нм  ЮЗнм -j-i-l У.....J J I J I I L- 1 1,2 1,4 1,6 1,8 2 2,2 2,4 2,6 Пу,эВ Рис. 5.13. Нормированная зависимость коэффициента собирания Q от энергии hv (длины волны x) фотонов в случае солнечного элемента Аи-m-AIq 4зСао 57AS-л-GaAs с барьером Шоттки. Варьируемая переменная - толщина (/слоя AlGaAs. Для сравнения показана спектральная зависимость коэффициента собирания Аи - GaAs элемента стым слоем (например, d = 200 нм), так как с ростом Vj снижается влияние различия ширины запрешенных зон в AlGaAs и GaAs. Снижению AEg способствует наличие области переменного состава на границе гетероперехода. Подобные измерения вновь возрождают интерес к моделям, основанньпу! на концепции скачков потенциала в гетеропереходных стрзпстурах. 210
ООО «Мягкий Дом» - это Отечественный производитель мебели. Наша профильная продукция - это диваны еврокнижка. Каждый диван можем изготовить в соответствии с Вашими пожеланияи (размер, ткань и материал). Осуществляем бесплатную доставку и сборку. Звоните! Ежедневно! (926)274-88-54 Продажа и изготовление мебели. Копирование контента сайта запрещено. Авторские права защищаются адвокатской коллегией г. Москвы. |