
(926)274-88-54
Бесплатная доставка.
Бесплатная сборка.
График работы:
Ежедневно. С 8-00 до 20-00.
Почта: soft_hous@mail.ru
 |
Звоните! (926)274-88-54 Бесплатная доставка. Бесплатная сборка. |
Ассортимент тканей График работы: Ежедневно. С 8-00 до 20-00. Почта: soft_hous@mail.ru |
  
|
Читальный зал --> Солнечные элементы  8 10 12qV/fT) Рис. 2.10. Зависимость/(Ь) от нормированного напряжения смещения qVlikT) [Choo, 1968]; теории Чу и СНШ обеспечивают приблизительно одинаковые результаты для р -п-перехода, представлеиного кривой 1 (D = 8 10cм 4 = 8 10*cм );  крнвая2 (% = 810* cм Л=8 10 см) рассчитана с помощью теории Чу; рекомбинационные центры имеют следующие параметры: Т>,о = 810 ** с; Гро = 4-10 *с; -8,9А:Г Рис. 2.11. Асимметричный гомогенный переход с неоднородным распределением рекомбинационных центров, в данном случае связанных с состояниями на границе раздела ционно-генерационных токов при повышенных прямых напряжениях смещения до такого низкого уровня, который отвечает насыщению в случае малой объемной концентрации носителей заряда. Теории СНШ и Чу успешно предсказывают форму вольт-амперной характеристики, однако в реальных диодах рекомбинационно-генерацион-ные токи, как правило, существенно выше, особенно для электронно-дырочных переходов, получаемых в материалах с шириной запрещенной зоны существенно большей, чем у кремния. Несмотря на то что токи, рассчитанные с помощью теории Чу, имеют даже еще более низкие значения по сравненюэ с токами, соответствующими теории СНШ, достоинство первой состоит в том, что она позволяет объяснить получение значений диодного коэффициента А больших или равных двум (типичных для гетеропереходов). До сих пор мы рассматривали приборы ср-и-переходом, в которых рекомбинационные центры, образующие единственный энергетический уровень, бьши распределены равномерно по всему объему. Если мы обратимся теперь к асимметричному гомогенному переходу, для которого характерна высокая скорость рекомбинации носителей на границе раздела р- и л-областей (такая структура может образоваться при зпитаксиаль-ном осаждении л-слоя на грязную подложку проводимости р-типа), то увидим, что На границе раздела положение уровней Ер и Ерр по отношению к E существенно изменяется в зависимости от степени легирования и типа проводимости областей, образующих переход (рис. 2.11). Взаимное расположение уровней Ер , Ерр, Е и Ej определяется скоростью рекомбинации U(x) носителей заряда и, следовательно, значением общего тока, протекающего через р - л-переход. Таким образом, сущест-54 вует еще один вид влияния асимметричности перехода на диодный коэффициент А. Данную модель можно использовать (во всяком случае это осуществимо принципиально) для описания гетеропереходов. 2.2.5. Вольт-амперные характеристики элементов с гомогенным переходом при различных механизмах переноса носителей заряда В солнечных элементах процесс переноса носителей заряда в большей или меньшей степени зависит также от ряда других факторов, таких, например, как последовательное и шунтирующее сопротивления, изменение механизма переноса при высоких прямых напряжениях смещения, распределение концентрации легирующей примеси (введенной диффузионным способом) и краевых эффектов. Последовательное сопротивление определяется объемным удельным сопротивлением слоев, входящих в структуру злемента, и контактным сопротивлением. При < сопротивлением обедненного слоя с достаточной степенью точности можно пренебречь. В большинстве случаев эквивалентную электрическую схему злемента представляют в виде цепи с сосредоточенными сопротивлениями (рис. 2.12), а его вольт-амперную характеристику записывают в виде / = /о{ехр[сКГ-/Л,)/(А:Г)] - l} + (К-/Л,)/Лр, (2.33) где /?s - последовательное и Лр - шунтирующее сопротивления. Отсюда видно, что влияние на вольт-амперную характеристику наиболее значительно при сильных токах (и высоких напряжениях смещения), тогда как влияние Rp - при низких напряжениях, когда ток, протекающий через переход, мал по сравнению с шунтирующим током. Полный ток, проходящий через элемент, представляет собой сумму диффузионной, рекомбинационно-генерационной и шунтирующей составляющих, которые обьршо рассматривают независимо друг от друга. Диффузионный ток, прямо пропорциональный л? преобладает в полупроводниках с малой шириной запрещенной зоны {Eg 1,1 эВ) и при больших обратных напряжениях смещения, в то время как рекомбина-ционно-генерационная составляющая играет наиболее важную роль в широкозонных полупроводниках и при малых напряжениях. На рис. 2.13 представлены темновые вольт-амперные характеристики идеализированного гомогенного перехода в Si при различных механизмах протекания тока. Как правило, довольно трудно экспериментальным путем разделить шунтирующий и рекомбинационно-генерационный токи, поскольку ко- Отношеяие плотностей рекомбинационно-генерационного (2.27) и диффузионного токов (2.12) Jrg/Jid=lWdkTNI(.2{Vj-V)T oqniL )]exp(,-qVK2kT)). Отсюда следует, что при больших Eg (которым отвечают малые и (или) низких V значение Jg превосходит J, А/см Рис. 2.12. Эквивалентная электрическая схема диода с последовательным Rg и туширующим Rp сопротивлениями 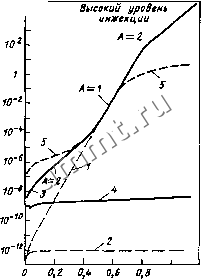 Рис. 2.13. Зависимости плотности тока J от напряжения смещения V для диода с обычным гомогенным переходом: I к2- диффузиоииая составляющая соответственно при прямом и обратном напряжениях смещения; 3 н4 - рекомбинациоиио-генерациои- иая составляющая при прямом и обратном напряжениях; левая часть кривой 5 характеризует изменение кривой 3 при учете шунтирующего сопротивления Rp = = 10* Омсм, правая часть кривой 5 - при учете последовательного сопротивления Rg = 0,1 Ом-см*; около кривой 3 указаны значения диодного коэффициента А; для обратных ветвей вольт-ампериых характеристик (кривые 2 я 4) значения напряжения, указанные иа оси абсцисс, следует увеличить в 10 раз эффшщент А может изменяться в зависимости от приложенного напряжения. Имеются данные, которые свидетельствуют о том, что происхождение шунтирующих токов связано с такими механизмами, как поверхностная проводимость вследствие рекомбинационно-генерационного процесса или туннепировакия носителей заряда по периметру или в области перехода при участии содержащихся здесь дефектов. При высоких прямых напряжениях смещения обычно преобладает диффузионный ток. Если в квазинейтральной области концентрация инжектированных носителей заряда превышает концентрацию основных носителей, то реализуются условия так называемого высокого уровня инжекции. При сохранении злектронейтральности образца Рр -Nj +Пр Пр положение квазиуровней Ферми при х=Хр определяется с помощью обычных соотношений. Произведение концентраций носителей заряда ПрРр = n]exp(qV/(kT))n, следовательно, граничное условие при х=Хр теперь имеет вид Ир(Хр) П;ехр(К/(2А:7)). (2.34) Рассуждая таким же образом, как и в 2.2.2, можно показать, что в условиях высокого уровня инжекции коэффициент А = 2 (рис. 2.13). Следует отметить, что в данном случае активные рекомбинационные центры расположены приблизительно посередине между уровнями Ef и Ерр (как и 56
ООО «Мягкий Дом» - это Отечественный производитель мебели. Наша профильная продукция - это диваны еврокнижка. Каждый диван можем изготовить в соответствии с Вашими пожеланияи (размер, ткань и материал). Осуществляем бесплатную доставку и сборку. Звоните! Ежедневно! (926)274-88-54 Продажа и изготовление мебели. Копирование контента сайта запрещено. Авторские права защищаются адвокатской коллегией г. Москвы. |